微纳电子器件课题组在高性能先进晶体管领域取得重要进展
2019年8月12日,《自然•材料》(Nature Materials)在线刊发了国家脉冲强磁场科学中心微纳电子器件课题组关于纳米厚度的铟锡氧化物(ITO)高性能电子器件的研究新成果。论文题目为“Nanometre-thin indium tin oxide for advanced high-performance electronics” (DOI:https://doi.org/10.1038/s41563-019-0455-8)。我校国家脉冲强磁场中心为论文第一单位,光电学院2015级博士生李晟曼为第一作者,其余作者包括课题组成员田猛串、高庆国、王梦飞、李调阳、胡倩澜与李学飞,吴燕庆教授为论文通讯作者。
近年来,随着可穿戴应用和便携式设备需求高涨,超低功耗电子器件一直是研究热点。基于新材料沟道的电子器件面临大面积材料合成、超短沟道器件性能、工艺与现有平面晶体管制备工艺的兼容性等诸多挑战。
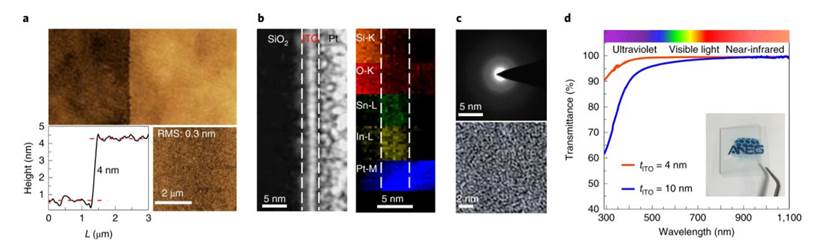
氧化铟锡,又被称为ITO,是一种迁移率较高、介电常数较低的宽禁带半导体,在未来5nm节点后极小沟道晶体管中具有重要的应用潜力。一直以来,因其基于简并掺杂而形成的高电导率被广泛用于显示及能源领域的透明导电电极,但是其类金属特性使得器件无法关断,从而限制了其在晶体管领域的应用。
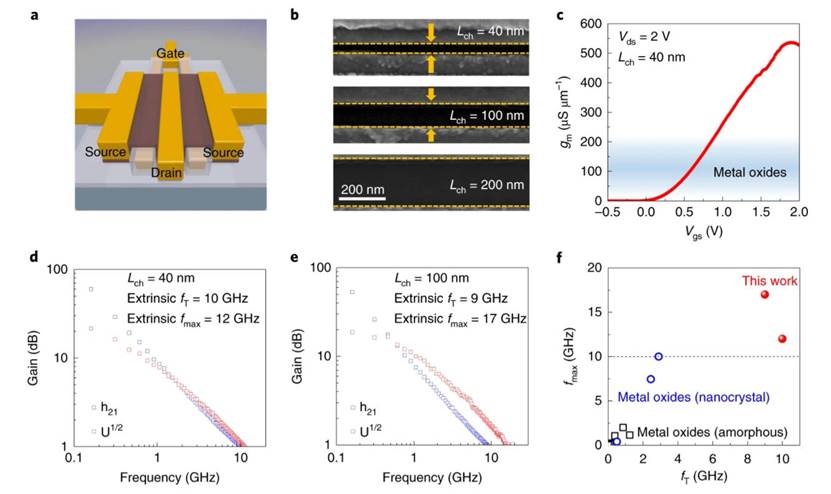
该研究团队通过精确控制材料本身沉积过程中的环境氛围及界面掺杂,实现了表面平整、一致性极高且厚度为4 nm的超薄ITO薄膜,并通过量子约束效应实现了沟道富余载流子的耗尽。通过使用La掺杂的HfO2(HfLaO)作为高k栅介质获得了等效物理厚度(EOT)0.8 nm,实现了优异的界面特性。此外,器件沟长从30 μm缩小至40 nm,依然保持极好的器件性能,其开关比大于9次方,亚阈斜率小于70 mV/dec。该工作中,40 nm ITO器件优异的短沟道效应主要归因于超薄ITO体特性和HfLaO高k介质材料特性,40 nm沟长的ITO器件的开态电流和开关比的综合表现远超过之前基于二维材料和其他金属氧化物器件。同时,利用该超薄体结构的ITO晶体管构建了逻辑反相器,在0.5 V偏压下反相器电压增益可达178。此外,40 nm沟长的ITO器件实际测试截止频率fT和最大振荡频率fmax可同时大于10 GHz,这些指标均也远超之前金属氧化物晶体管与二维半导体。该成果为未来先进的低功耗电子器件尺寸缩小至5 nm以后的进一步拓展提供了前景。
以上工作得到了国家自然科学基金委员会及我校等各类项目资助,并得到国家脉冲强磁场科学中心实验平台的大力支持,以及武汉光电国家研究中心微纳加工平台、华中科技大学分析测试中心等单位的技术支持。
论文链接:https://www.nature.com/articles/s41563-019-0455-8